一直以來,美國都認為華為能夠在短時間內突出重圍一定是用了美國的技術,甚至在華為研制出麒麟9000S芯片之后還煞有介事地派出相關部門要找出證據,但調查至今,美國那邊一點動靜都沒有。
根據金融街報道,華為又申請了一項關于“半導體封裝”技術的專利。消息一經發(fā)布,包括德邦科技在內的多家企業(yè)股價一路飆升。值得注意的是,根據天眼查顯示,華為申請這項專利的日期是在十月末,也就是說,華為早在幾天前就已經有了這項技術了。
據了解,這項半導體封裝技術,包括第一塊底部,半導體芯片,引線框和密封劑。該密封劑的底部主面包括四部分:第一部分在第一平面中延伸,第二部分在第二平面中延伸,第三部分在第一過渡區(qū)中延伸,第四部分在第二過渡區(qū)中延伸。
近日,華為在半導體封裝領域的一項重要專利獲得了公布。這項專利名為“一種半導體器件的封裝方法和裝置”,它為華為在半導體封裝領域的進一步發(fā)展奠定了基礎。
這項專利主要涉及的是一種半導體器件的封裝方法和裝置,它采用先進的封裝技術,可以有效地提高半導體器件的可靠性和性能。具體來說,該專利通過在封裝過程中對芯片進行固定和保護,同時實現(xiàn)高效的熱傳導和電信號傳輸。這種封裝方法不僅提高了芯片的性能,還增強了芯片的穩(wěn)定性和耐用性。
天眼查顯示,華為技術有限公司“半導體封裝”專利公布,申請公布日為10月31日,申請公布號為CN116982152A。

圖片來源:天眼查
專利摘要顯示,本公開涉及一種半導體封裝,該半導體封裝包括:第一襯底、半導體芯片、引線框和密封劑。該密封劑的下主面包括在第一平面中延伸的第一部分、在第二平面中延伸的第二部分、在該第一平面與該第二平面之間的第一過渡區(qū)中延伸的第三部分,以及在該第二平面與至少一個引線之間的第二過渡區(qū)中延伸的第四部分。該密封劑的該第一部分和該第一襯底的下主面在相同的第一平面中延伸,該第一平面形成該封裝的下散熱表面。該密封劑的該第二部分、該第三部分和該第四部分的尺寸被設置為在該密封劑的該第一部分與該至少一個引線之間保持第一預定義最小距離。
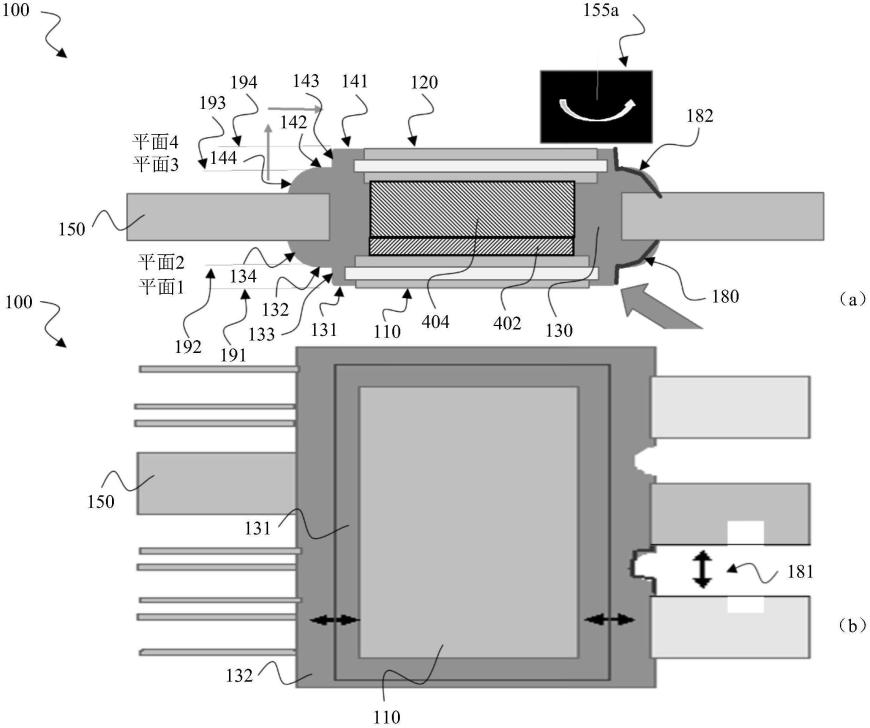
圖片來源:天眼查
該專利的公布是華為在半導體領域不斷努力的結果。隨著全球半導體市場的競爭越來越激烈,華為在半導體技術方面的投入也在不斷增加。這項專利的獲得,不僅為華為在半導體封裝領域的技術實力提供了有力的證明,也為華為在未來半導體市場的發(fā)展提供了重要的支撐。
此外,該專利所涉及的封裝方法和裝置也為其他行業(yè)提供了新的發(fā)展思路。例如,在汽車、航空航天、醫(yī)療等領域,該專利的技術可以應用于各種半導體器件的封裝,從而提高了這些領域的電子設備的可靠性和性能。
總的來說,華為的這項專利在半導體封裝領域具有重要的意義。它不僅為華為的發(fā)展提供了技術支持,也為其他行業(yè)的發(fā)展提供了新的思路。在未來,我們期待看到這項技術在更多領域的應用和發(fā)展。






