不久前,有媒體報道稱,臺積電正逐步加大先進封裝投資力度,并扶植相關設備、材料商構建生態鏈,以綁住蘋果等大客戶訂單,再次引起業界對先進封裝的重點關注。
隨著摩爾定律增速放緩,而終端應用產品日漸往智能化趨勢發展,半導體先進封裝在提升芯片產品性能中扮演著日益重要的角色。
先進封裝大勢所趨
眾所周知,全球各地相繼啟動5G商用,隨著5G時代到來,5G通訊、物聯網、人工智能、自動駕駛、智能家居、高性能計算等應用市場日益發展壯大,對芯片產品需求也大幅增長,推動全球半導體行業回暖,同時亦對芯片產品提出了更高要求。
終端產品在向輕、薄、短、小等微型化發展,但功能性卻日益增強,促使芯片產品向低價格、高效能、高整合度、更低成本的趨勢演進。一直以來,摩爾定律指引著集成電路不斷向前發展,縮小晶體管尺寸的同時亦可提升產品性能,但隨著摩爾定律接近極限、增速趨緩,先進封裝技術成為業者滿足終端產品性能提升需求的另一路徑。
據了解,先進封裝技術主要包括倒裝芯片(FC--Flip Chip)、晶圓級芯片規模封裝(WLCSP-Wafer Level Chip Scale Package)、扇出型芯片封裝(Fan-out WLP)、系統級封裝(SiP--System in a Package)、2.5D/3D封裝等,從技術發展路徑看有兩種,一種路徑是尺寸減少,使其接近芯片大小,如FC、WLCSP、Fan-Out ,另一種路徑是功能性發展,即強調異構集成,在系統微型化中提供多功能,如SiP、3D封裝等。
簡單而言,WLCSP是對整個晶圓進行封裝測試后再切割得到單個成品芯片,封裝后的體積與集成電路的裸芯片基本一致;Fan-out WLP即I/O bumping通過RDL層擴展至IC芯片周邊,在滿足I/O數增大的前提下又不至于使Ball pitch過于縮小;SiP是利用各種堆疊集成技術,將多個具有不同功能的芯片及被動元件集成到尺寸更小的封裝組件上形成一個系統......
整體看來,傳統封裝技術成熟、產能較大,對于中低端產品或者標準器件而言,傳統封裝更具穩定性及規模優勢;相較于傳統封裝,先進封裝具有尺寸更小、封裝密度更高、可容納引腳數量多、集成度高、性能更強、封裝效率更高、可降低生產成本等優勢,可滿足對性能要求高的產品需求。
具體來說,不同的先進封裝技術具有各自的優勢,如SiP可以最大限度地優化系統性能、避免重復封裝、縮短開發周期、降低成本、提高集成度等,可廣泛應用于無線通訊、汽車電子、醫療電子、計算機等領域;3D封裝可提高硅片效率、縮短延遲、降低功耗等,主要應用于SD存儲器、3D Soc芯片、CIS、RF濾波器、指紋芯片、MEMS等。
有相關數據顯示,這幾年先進封裝市場保持著良好的增長勢頭,將以8%的年復合增長率成長,市場規模預計到2024年將達440億美元。目前,倒裝芯片(FC)占據先進封裝市場較大份額,扇出型芯片封裝(Fan-out WLP)、系統級封裝(SiP)、3D封裝等技術增速明顯。
目前,市場已反應對先進封裝的強烈需求,如高性能計算方面,高性能計算機以及高頻、高速、高可靠、低延遲、微系統集成等需求推動了FC、2.5D/3D、Fan-Out等先進封裝技術的應用;再如射頻前端模組、毫米波所需的天線封裝模組亦有更多SiP需求,智能手表、TWS耳機、手機攝像頭等亦對SiP有所需求。
先進封裝已成大勢所趨,吸引了半導體行業各大廠商競相投資布局,一場先進封裝技術競逐賽已拉開帷幕,一時間競爭者眾多。
臺積電、三星等大廠搶攻
半導體封測行業包括IDM(整合一體化制造服務)、OSAT(專業封測代工)兩大商業模式,這幾年,該行業正在由IDM模式向OSAT模式轉型,OSAT廠商逐漸在封測業占據主導地位。
在傳統封裝領域上,OSAT廠商具備規模及成本優勢,占據絕對地位;然而,在先進封裝領域,這幾年IDM及晶圓代工廠商大力發展先進封裝技術,正在蠶食原本屬于OSAT廠商的市場份額,盡管OSAT廠商目前亦占據較多的先進封裝產能,但仍將面臨來自跨界競爭壓力。
一位業內人士聲稱,早前由于先進封裝技術研發需要投入巨資、技術門檻亦較高,傳統OSAT只有頭部廠商有條件涉足,臺積電為鎖定大客戶訂單、滿足客戶對于產品性能升級需求以及快速交付產品等,這幾年大舉進軍先進封裝領域,三星、英特爾等IDM廠商亦在重點布局,臺積電等在先進封裝技術領域已走在前列。
No.1 臺積電
臺積電被視為先進封裝技術領先者,其開發了包括CoWoS(Chip on Wafer on Substrate)、整合型扇出封裝技術InFO(Integrated Fan-Out, InFO)、SoIC(System on Integrated Chip, SoIC)等創新技術。憑借其先進封裝技術優勢,臺積電與蘋果簽署了獨家代工合同,獨占蘋果iPhone代工訂單多年,包括iPhone 7、iPhone 8、iPhone X等多代產品。
對于臺積電而言,先進封裝已成為其持續發展的成熟業務。目前,臺積電的InFO已進入第四代的量產。根據年報,2019年臺積電已大量生產第四代整合型扇出層疊封裝技術(Integrated Fan-Out Packageon-Package, InFO-PoP),第五代InFO-PoP和第二代整合型扇出暨封裝基板技術(InFO on Substrate, InFO_oS)也分別通過了認證。
此外,臺積電于2012年推出CoWoS技術現已發展至第四代、第五代,第四代CoWoS藉由擴大硅中介層的尺寸而進一步提高封裝整體性能。2019年年報顯示,其正在開發的第五代CoWoS的中介層面積高達2400平方毫米,并同時考慮了新的芯片架構,例如小芯片、系統整合芯片以及第三代高頻寬記憶體(HBM3)。
臺積電還開發了創新的晶圓級封裝技術——系統整合芯片(System on Integrated Chip, SoIC),是以關鍵的銅到銅接合結構,搭配TSV以實現最先進的3D IC技術,可將多個小芯片整合成一個面積更小與輪廓更薄的系統單晶片,根據2019年年報,臺積電已完成SoIC制程認證,開發出微米級接合間距制程, 并獲得極高的電性良率與可靠度數據。
No.2 英特爾
除了臺積電,英特爾作為IDM廠商在推進先進制程的同時也在發力先進封裝技術,希望通過晶體管、封裝和芯片設計協同優化進步以推動摩爾定律發展演進。
2017年,英特爾推出了EMIB(Embedded Multi-Die Interconnect Bridge,嵌入式多芯片互連橋接)封裝技術,可將不同類型、不同工藝的芯片IP靈活地組合在一起,類似一個松散的SoC。2018年12月,英特爾再推出Foveros 3D堆疊封裝技術,可以通過在水平布置的芯片之上垂直安置更多面積更小、功能更簡單的小芯片來讓方案整體具備更完整的功能。
2019年7月, 英特爾在SEMICON West 大會上分享了三項全新先進封裝技術技術,Co-EMIB、全方位互連技術ODI(Omni-Directional Interconnect)、全新裸片間接口技術MDIO。Co-EMIB可以理解為EMIB和Foveros兩項技術的結合,在水平物理層互連和垂直互連的同時,實現Foveros 3D堆疊之間的水平互連。
No.3 三星
三星電子方面,媒體報道稱其將在先進封裝上加大投入,以期與臺積電一較高下。據了解,2015年在丟失蘋果iPhone處理器代工訂單后,三星電子成立了特別工作小組,目標開發先進封裝FOPLP技術。2018年,三星電子FOPLP技術實現商用,應用于其自家智能手手表Galaxy Watch的處理器封裝應用中。
2019年10月,三星電子宣布已率先開發出12層3D-TSV技術。三星電子方面聲稱,這是大規模生產高性能芯片的最具挑戰性的封裝技術之一,該技術可垂直堆疊12個DRAM芯片,它們通過60000個TSV互連,每一層的厚度僅有頭發絲的1/20。
除了臺積電、英特爾、三星電子等幾家在先進封裝領域表現突出外,還有如存儲器大廠美光也開始自建封測產線、中國本土晶圓代工廠中芯國際與OSAT廠商長電科技合作投建封測廠中芯長電主攻先進封裝......
本土OSAT廠商競相布局
臺積電等已跑在前方,OSAT企業亦緊隨其后不斷發力先進封裝。
目前,OSAT產業已形成較穩定的競爭格局,根據集邦咨詢旗下拓墣產業研究院發布的2020第一季全球前十大封測業者排名,日月光、安靠、長電科技位列前三,后面依次為矽品、力成、通富微電、華天科技、京元電、南茂、頎邦。從地區劃分來看,全球前十大封測業者主要分布于中國大陸和中國臺灣,其中中國大陸占據三席。

如今,先進封裝已成為OSAT大廠角力新戰場,日月光等頭部廠商等持續在2.4D/3D IC、SiP、Fan-out/Fan-in WLP、Flip Chip、Bumping及Optical Package等領域研究開發,先進封裝技術在OSAT企業處于領先地位。
大陸方面,盡管本土涉足封測業務的企業數量不少,但大部分整體規模較小,主要從事低腳數封裝業務,擁有先進封裝技術的內資企業僅為少數。不過,長電科技、通富微電、華天科技、晶方科技等幾大廠商這幾年經過自主研發及兼收并購等,整體技術水平得到較大提升,在先進封裝技術上取得較為明顯的突破,與國際先進水平的差距正在逐漸縮小。
No.1 長電科技
本土封測龍頭廠商長電科技在并購吸收了新加坡封測廠商星科金朋后,技術水平大幅提升,已擁有Fan-out eWLB、WLCSP、SiP、BUMP、PoP等系列先進封裝技術,WLCSP、FOWLP產品已大規模量產出貨,亦具備完整的3D TSV封裝技術開發與量產能力。年報顯示,長電科技2019年先進封裝生產量284.81億只、銷售量283.16億只,實現銷售額200.46億元,銷售占比達85.21%。

(圖片來源:截圖于長電科技2019年年度報告)
2020年5月,長電科技宣布研發出更高密度的雙面封裝SiP工藝,成功于2020年4月通過全球行業領先客戶的認證,實現雙面封裝SiP產品的量產。在這項技術工藝中,長電科技設計的雙面封裝SiP產品成功應用了雙面高密度、高精度SMT工藝,將大量的主被動元器件貼裝在基板兩面,器件間的間距更是小到只有幾十微米。
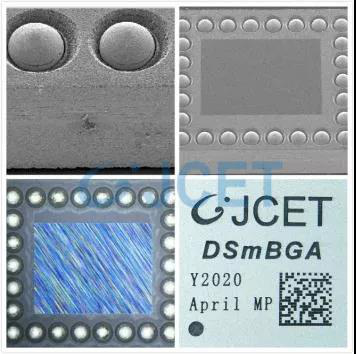
(圖片來源:長電科技量產雙面封裝SiP產品)
在不斷提高先進封裝技術水平的同時,長電科技近兩年來也在不斷擴充先進封裝的產能。
今年6月3日,長電集成電路(紹興)有限公司300mm集成電路中道先進封裝生產線項目一期廠房工程正式啟動。該項目總投資額為80億元,其中一期達產后將具備年封裝300mm芯片48萬片的能力,主要聚焦于先進封裝領域,將被廣泛應用于5G相關領域。
半導體聯盟報道,7月7日,長電科技高密度系統級封裝模組項目廠房順利封頂,新廠房建筑面積超4萬平方米,預計2021年1月交付并投入使用,模組封裝產品年產量將達36億顆。該項目將進一步提升長電科技的高端封裝技術能力與產能。
No.2 通富微電
通富微電方面,這幾年收購了AMD蘇州及AMD檳城各85%股權,并先后在南通、合肥、廈門各地布局,產能迅速擴張,先進封裝技術也得到較大幅度提升。根據其2019年年報,通富微電WLCSP、FC、SiP、高可靠汽車電子封裝技術、BGA基板設計及封裝技術及高密度Bumping技術等已全部實現產業化,2.5D封裝技術研發中。
在通富微電的崇川、蘇通、合肥、蘇州、馬來西亞檳城五處生產基地以及廈門參股公司中,通富超威蘇州及通富超威檳城在先進封裝領域具有較強的技術優勢,形成了以倒裝封裝為主的技術線路,主要量產技術包括FCBGA、FCPGA、FCLGA、MCM,其主要從事CPU、GPU、APU、游戲機芯片等高端產品的封裝測試。
目前,通富微電正擬定增募資不超過40億元投建集成電路封裝測試二期工程、車載品智能封裝測試中心建設、高性能中央處理器等集成電路封裝測試項目等項目。這次的募投項目主要是進一步將先進封裝業務產業化、規模化。近日公告披露,通富微電這次定增申請已獲得中國證監會的批準。
No.3 華天科技
至于華天科技,這幾年亦通過并購整合及自主研發不斷提升先進封裝技術和產能。2014年11月,華天科技宣布收購美國公司FCI及其子公司,隨后又于2019年收購馬來西亞封測廠商Unisem。根據華天科技2019年年報,公司現已掌握了MCM(MCP)、BGA/LGA、3D、SiP、MEMS、FC、TSV、Bumping、Fan-Out、WLP、Memory等先進封裝技術,完成三維垂直互連硅基埋入式扇出封裝技術(3D-eSiFO)的研發,實現eSiFO封裝技術的三維垂直互連集成封裝。
同樣的,華天科技亦在不斷擴產及布局先進封裝。2018年7月,華天科技宣布將在南京浦口經濟開發區投資建設南京集成電路先進封測產業基地項目。該項目總投資80億元、分三期建設,主要進行存儲器、MEMS、人工智能等集成電路產品的封裝測試。最新消息顯示,南京基地于7月18日正式投產。
除了新建南京基地外,華天的昆山基地也進行了擴建。2018年11月,華天科技昆山公司高可靠性車用晶圓級先進封裝生產線項目簽約,該項目總投資20億元,將利用華天昆山公司現有空地建設廠房,項目達產后年新增傳感器高可靠性晶圓級集成電路先進封裝可達36萬片。近日有消息顯示,該項目已進入沖刺階段。
No.4 晶方科技
與前三者略有不同,晶方科技本身專注于傳感器領域的先進封裝技術服務,具備8英寸、12英寸的先進WLCSP技術規模量產能力,亦是國內主要的指紋識別TSV先進封裝廠商。
晶方科技早年引進吸收了以色列晶圓封裝技術,2014年通過收購DRAM專業封測廠智瑞達電子,擁有了LGA、BGA、SiP模組等封裝技術和模組制造能力,并推出了傳感器扇出型系統級(Fan-out SiP)封裝技術。2019年,晶方科技又參與并購荷蘭Anteryon公司,拓展了其光學器件的設計與技術制造能力。
目前,晶方科技正在定增募資不超過14.02億元用于集成電路12英寸TSV及異質集成智能傳感器模塊項目。據披露,該項目主要建設內容圍繞影像傳感器和生物身份識別傳感器兩大產品領域,項目建成后將形成年產18萬片的生產能力。該定增申請已獲中國證監會發行審核委員會審核通過。
綜上可見,大陸本土四大OSAT廠商的先進封裝技術已然具備一定水平并基本形成產業化能力,亦正在競相進一步加碼布局,以期進一步縮小與國際先進水平的差距。不過,隨著海外并購審核趨嚴以及可選標的減少,本土廠商先進封裝技術發展未來將更多地依靠自主研發及國內整合。
結語
總體而言,先進封裝已成群雄必爭之地,隨著晶圓代工廠和IDM廠商的挺進以及OSAT企業的加碼布局、市場需求的持續增長,圍繞先進封裝的競逐賽將愈演愈烈,本土封測廠商能否在這場競逐賽中優勝,對于大陸封測產業甚至整個半導體產業均至關重要。






