5G及IoT終端需求發展,SiP系統級封裝技術提高了人類生活的便利性
「Semicon Taiwan 2019」展會期間,特別針對半導體的未來發展趨勢舉行「科技智庫領袖高峰會」,封測大廠日月光執行長吳田玉為半導體封測產業的前世今生及未來發展方向提出見解。
由于半導體摩爾定律限制,使得線寬不斷微縮、晶體管密度逐步升高,人們從早期的個人計算機發展并搭配QFP(Quad Flat Package)導線架封裝方法,演進至現今5G通訊及IoT的SiP(System in Package)系統級先進封裝技術。
摩爾定律貢獻于終端產品演進,發現它不只帶動半導體制程的不斷精進,也引領封裝技術的逐步提升,遂逐步將終端應用推向智慧化,而5G及IoT應用正開啟人類生活的新視野。日月光集團特別在5G通訊應用上,將藍牙芯片及MCU(微控制器)藉由SiP封裝技術整合為一。
在IoT部分,則利用長距離無線通訊(LoRa)芯片搭配MCU進行封裝。透過上述異質整合SiP封裝技術,使得真無線藍牙耳機及遠距離傳輸傳感器等相關終端產品應用變得更加多元,提高人類生活的便利性。
異質整合能力是決定未來封測技術發展的重要指標
面對現階段半導體封測技術之發展,異質整合能力將是評估廠商未來發展性的重要指標。針對異質整合的發展特性,將有以下幾個評估要點:考量整體的機械性質、元件結構間的熱能變化,以及適當材料及程序操作,還有芯片彼此間的互通有無等。
由于必須考量上述因素,在目前摩爾定律限制下,廠商面對整體系統的異質整合程度時,必須衡量自身先進制程及封裝技術能力,因此對于現行半導體制造與封測代工廠來說,亟需投入相關封測技術之研發(如2.5D/3D封裝、SiP、FOWLP等),以實現終端應用之封裝需求。
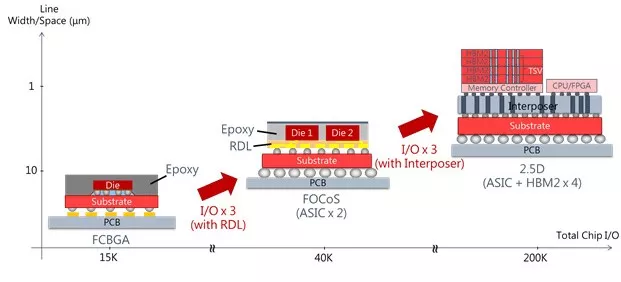
▲2.5D封裝技術演進圖,source:日月光
值得一提,日月光特別針對AI之FPGA(現場可程序化邏輯閘陣列)芯片,試圖從傳統FCBGA封裝方式,逐步衍生至極低線寬比、極高接腳密度之2.5D封裝技術,藉此提升自身異質整合的能力。






