隨著半導(dǎo)體技術(shù)的持續(xù)演進(jìn),傳統(tǒng)的二維芯片縮放規(guī)則受到物理極限的挑戰(zhàn),尤其是摩爾定律在微小化方面的推進(jìn)速度放緩。為了繼續(xù)保持計(jì)算性能和存儲(chǔ)密度的增長(zhǎng)趨勢(shì),業(yè)界開始轉(zhuǎn)向三維集成電路設(shè)計(jì)與封裝技術(shù)的研發(fā)。混合鍵合技術(shù)就是在這樣的背景下應(yīng)運(yùn)而生,作為一種創(chuàng)新的互連解決方案,它能夠?qū)⒉煌δ艿男酒蚓A以垂直堆疊的方式進(jìn)行集成,從而實(shí)現(xiàn)更高的集成度、更快的數(shù)據(jù)傳輸速度以及更低的功耗。
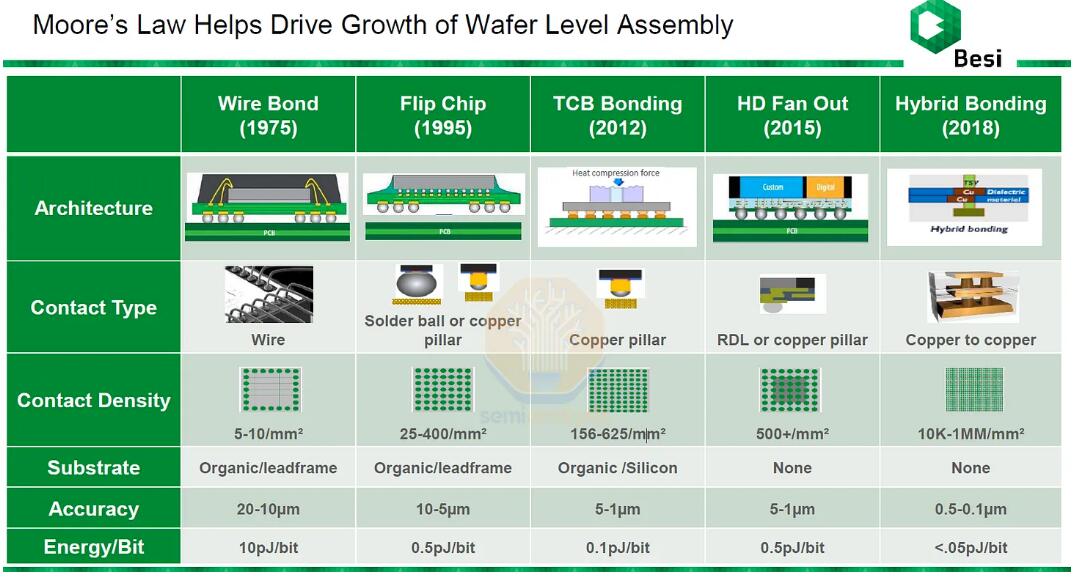
混合鍵合(Hybrid Bonding)是一種先進(jìn)的集成電路封裝技術(shù),主要用于實(shí)現(xiàn)不同芯片之間的高密度、高性能互聯(lián)。這種技術(shù)的關(guān)鍵特征是通過直接銅對(duì)銅的連接方式取代傳統(tǒng)的凸點(diǎn)或焊球(bump)互連,從而能夠在極小的空間內(nèi)實(shí)現(xiàn)超精細(xì)間距的堆疊和封裝,達(dá)到三維集成的目的。
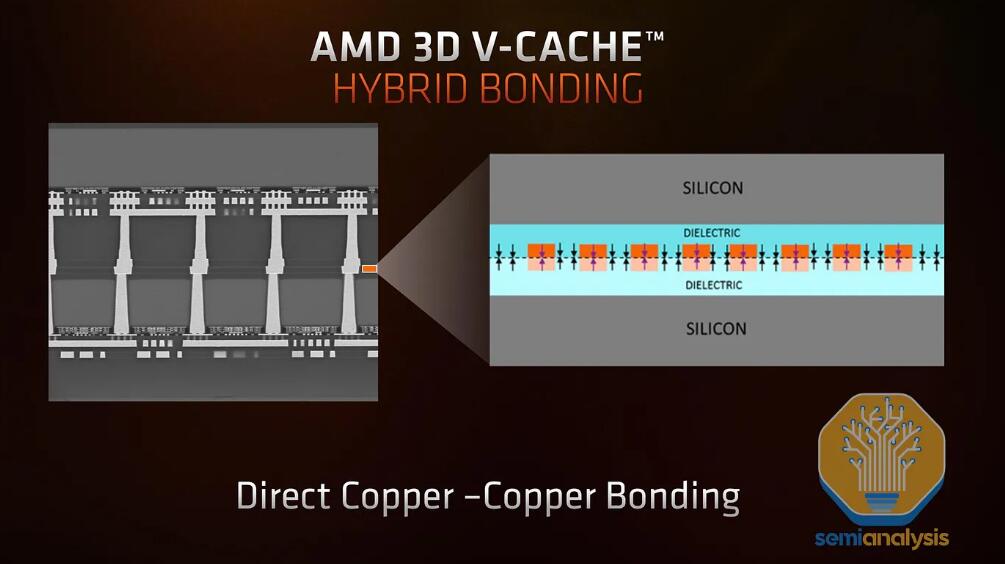
在混合鍵合工藝中,兩個(gè)或多個(gè)芯片的金屬層(通常是銅層)被精密對(duì)準(zhǔn)并直接壓合在一起,形成直接電學(xué)接觸。為了保證良好的連接效果,需要在芯片表面進(jìn)行特殊的處理,例如沉積一層薄且均勻的介電材料(如SiO2或SiCN),并在其上制備出微米甚至納米級(jí)別的銅墊和通孔(TSV)。這些銅墊和通孔將芯片內(nèi)部的電路與外部相連,使得數(shù)據(jù)傳輸速度更快、功耗更低,同時(shí)極大地提升了芯片的集成度。
混合鍵合技術(shù)的優(yōu)勢(shì)包括:
極高密度互連:相較于傳統(tǒng)鍵合技術(shù),混合鍵合可以實(shí)現(xiàn)亞微米級(jí)乃至納米級(jí)的互連間距,允許在更小的面積上放置更多的連接點(diǎn),大大增加了芯片間的數(shù)據(jù)通信帶寬。
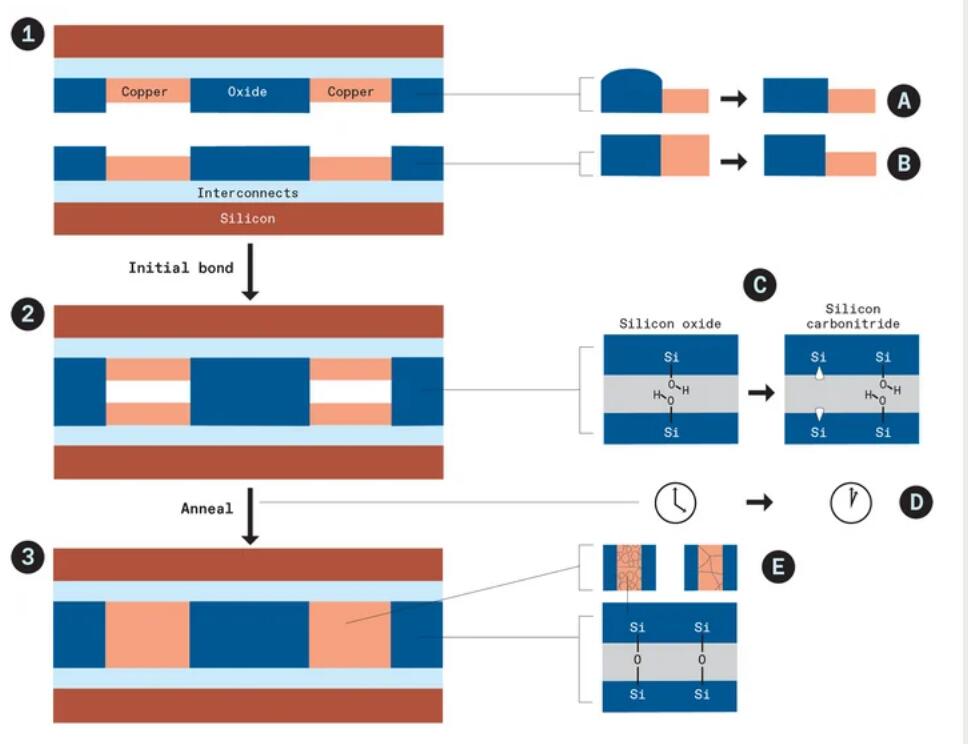
低電阻、低延遲:由于省去了中間介質(zhì)如焊錫等材料,直接銅對(duì)銅的連接具有更低的電阻,降低了信號(hào)傳輸?shù)哪芰繐p失,同時(shí)也減少了信號(hào)傳播的時(shí)間延遲。
更好的散熱性能:緊湊的結(jié)構(gòu)和直接的導(dǎo)電路徑有助于改善熱管理,降低發(fā)熱問題,對(duì)于高性能計(jì)算、人工智能和其他高速運(yùn)算應(yīng)用尤其重要。
小型化與高性能封裝:混合鍵合技術(shù)推動(dòng)了2.5D和3D封裝的發(fā)展,使得芯片能夠以垂直堆疊的方式整合到一起,顯著縮小了最終產(chǎn)品的體積,并提升整體系統(tǒng)性能。
目前,混合鍵合技術(shù)已被各大半導(dǎo)體廠商如英特爾、AMD、臺(tái)積電、三星等采用,在圖像傳感器、高端處理器、HBM內(nèi)存堆棧、AI加速器等領(lǐng)域取得了突破性進(jìn)展。然而,混合鍵合技術(shù)的實(shí)施也面臨著諸多挑戰(zhàn),如嚴(yán)格的潔凈室環(huán)境要求、高精度對(duì)準(zhǔn)工藝、以及確保大面積晶圓上數(shù)十億個(gè)連接點(diǎn)都成功鍵合的良率控制等難題。盡管如此,隨著市場(chǎng)需求和技術(shù)進(jìn)步,混合鍵合將繼續(xù)成為未來先進(jìn)封裝領(lǐng)域中的關(guān)鍵技術(shù)之一。
目前常見的應(yīng)用場(chǎng)景:
1. 3D芯片堆疊:混合鍵合被廣泛應(yīng)用于處理器和內(nèi)存堆棧中,例如AMD的3D V-Cache技術(shù)和HBM高帶寬內(nèi)存的多層堆疊。通過混合鍵合,可以將CPU與額外緩存芯片緊密連接在一起,顯著提升系統(tǒng)性能;同時(shí),在圖形處理單元(GPU)和高性能計(jì)算領(lǐng)域,將內(nèi)存芯片直接堆疊到邏輯芯片上,極大地提高了數(shù)據(jù)帶寬和訪問效率。
2. 異構(gòu)集成:混合鍵合技術(shù)也促進(jìn)了異構(gòu)系統(tǒng)的集成,使得各種不同工藝節(jié)點(diǎn)制造的芯片可以有效地結(jié)合在一起,形成一個(gè)單一的高性能封裝體。例如,將射頻芯片、傳感器、處理器等多種類型的芯片整合在同一封裝內(nèi),優(yōu)化了物聯(lián)網(wǎng)設(shè)備、智能手機(jī)和其他智能硬件的空間利用和整體性能。
3. 圖像傳感器:混合鍵合在CMOS圖像傳感器領(lǐng)域也有重要應(yīng)用,如背照式(BSI)傳感器和堆疊式傳感器等,其中底層的像素陣列通過混合鍵合技術(shù)與頂層的電路層相連,降低了光路損失并實(shí)現(xiàn)了更小型化的相機(jī)模組設(shè)計(jì)。
4. 汽車電子與5G通信:對(duì)于需要高度集成、低延遲和高效能的汽車?yán)走_(dá)、自動(dòng)駕駛芯片以及5G基站和終端芯片而言,混合鍵合技術(shù)提供了一種理想的封裝方案,有助于提高系統(tǒng)可靠性,并滿足嚴(yán)苛的應(yīng)用環(huán)境需求。
混合鍵合作為先進(jìn)封裝技術(shù)的核心組成部分,正逐漸成為推動(dòng)半導(dǎo)體行業(yè)向三維集成發(fā)展的重要驅(qū)動(dòng)力,并在眾多關(guān)鍵市場(chǎng)領(lǐng)域發(fā)揮著越來越重要的作用。隨著技術(shù)不斷成熟和成本效益的提高,預(yù)計(jì)未來混合鍵合技術(shù)將在更多復(fù)雜且要求極高的系統(tǒng)級(jí)封裝解決方案中得到廣泛應(yīng)用。






